首页 > 心得体会 > 学习材料 / 正文
MOSFET瞬态脉冲热阻的测量及其变化规律研究
2022-09-07 20:45:03 ℃





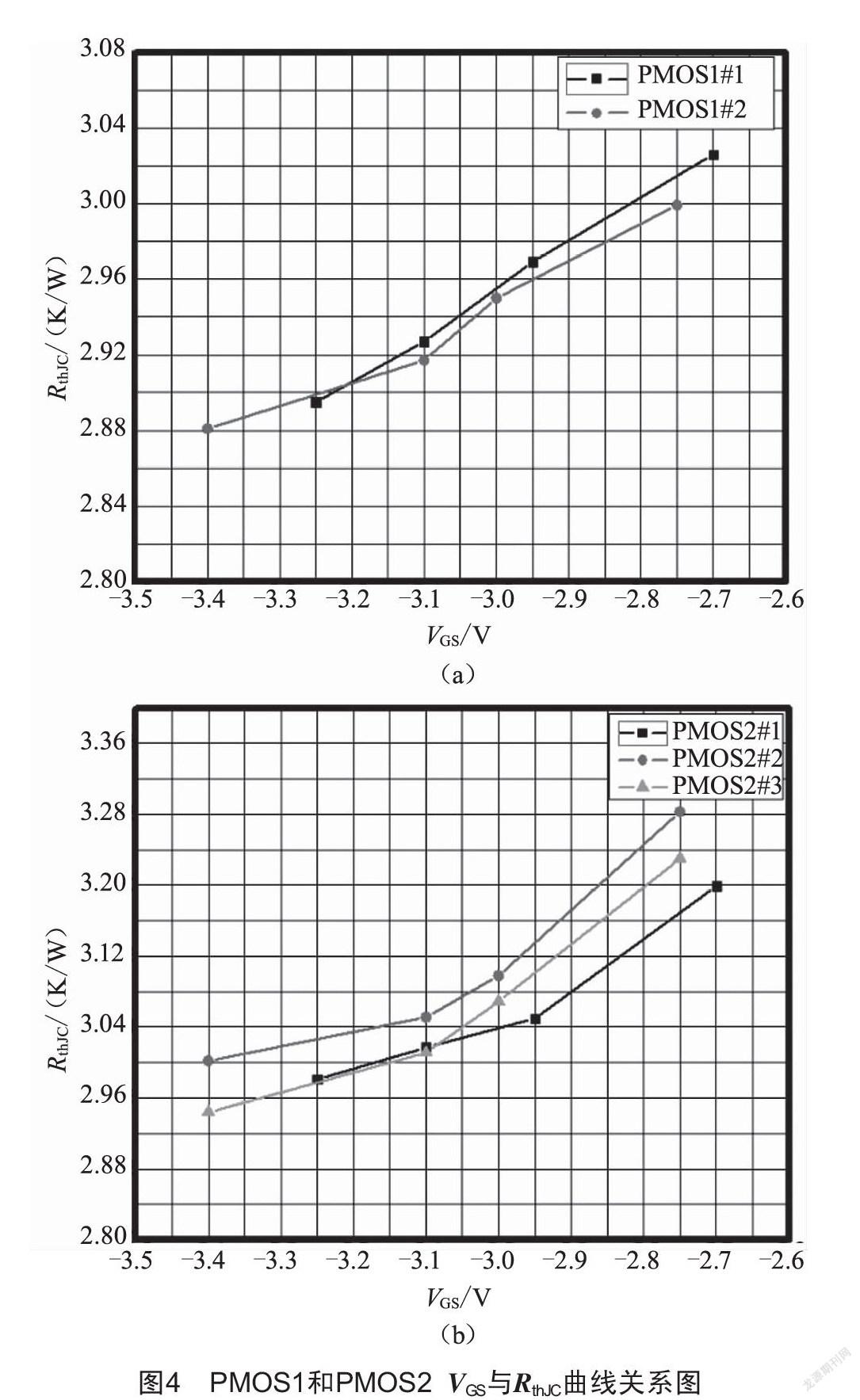

摘 要:半导体器件正不断朝高功率、高电压、大电流方向发展,随之而来的是高功率带来的发热和散热难题。现以MOSFET作为研究对象,对瞬态热阻进行测量与分析,研究MOSFET瞬态热阻在不同栅极电压下的变化规律。实验结果表明,MOSFET瞬态热阻随栅极电压VGS绝对值的增大而减小,但对于不同的器件,热阻减小的幅度不同。通过分析得到引起上述现象的原因在于,当栅极电压变化时,沟道和漂移区的物理尺寸发生变化,从而对热流的扩散长度产生影响,改变了通道的导通电阻分布,并且导电通道内的峰值温度点会发生变化。
关键词:MOSFET;瞬态脉冲热阻;栅极电压;瞬态双界面法
中图分类号:TN407 文献标志码:A 文章编号:1671-0797(2022)13-0001-04
DOI:10.19514/j.cnki.cn32-1628/tm.2022.13.001
0 引言
作为一种重要的半导体元器件,金属—氧化物半导体场效应晶体管MOSFET被广泛应用于整个电子行业。随着MOSFET逐渐微型化、集成化,器件工作时产生的热量会更加集中,从而引起温度升高,当温度升高到大于器件最大允许温度时,器件会性能退化甚至损坏。作为器件的重要热学参数,结温可以直观反映出器件的散热能力。结温可以通过热阻计算得到,从而为器件的封装与可靠性设计提供参考思路,在器件选型时也可以提供热性能参考。
早期对MOSFET热阻的研究主要集中在验证不同测试方法的准确性、外部环境改变对热阻测试的影响、芯片设计和封装对热阻的影响等等,很少有人研究MOSFET热阻与栅极电压的关系。本文通过研究对MOSFET施加不同栅极电压时的瞬态脉冲热阻,分析MOSFET热阻的变化规律,从而选择合适的栅极工作电压范围,避免MOS管在工作过程中因产生大量热量而造成损坏的问题。
1 热传输与热阻
1.1 热传输
根据热力学第二定律,当两个物体之间存在温度差时,两者之间发生热量传递,热量从高温物体传递到低温物体,该过程是一个自发过程。
下面用功率器件解释一下热量传递的过程:当功率器件工作时,在芯片处产生热量,由于存在温度差,热量通过芯片与封装体的接触传递到封装体内表面,然后通过介质—封装体传递到封装体外表面(器件外壳),最后将热量传递到周围环境中。该过程称为传热过程。
在上述热量传递过程中,热量从芯片传递到封装内表面、从封装内表面传递到封装外表面的过程和从封装外表面传递到周围环境的过程存在本质上的不同。在前两个热量传递过程中,芯片与封装体之间、封装体与封装体之间分子相对静止,不存在相对运动,该过程被称为导热过程;而在最后一个热量传递过程中,环境中空气分子与封装外表面之间存在相对运动,并且空气分子之间也存在相对运动,该过程被称为对流过程。另外,封装外表面与周围环境中不接触的物体之间也存在热量传递,该过程被称为辐射换热。综上所述,一般物体的热量传递过程由导热、对流换热和辐射换热三部分组成[1]。
1.2 热阻
热阻是热量传递时所受的阻力,为方便理解,热阻可表示为施加1 W热功率所引起的温升,其单位为K/W或℃/W,是表示物体热性能的物理量。
在对器件施加电压时,器件内形成电场产生电流,载流子在电场作用下速度变大。当载流子与晶格发生碰撞后,一部分电能将转化成热能,这部分热能以声子的形式在晶格间传输,引起芯片温度升高。当芯片温度升高到大于环境温度时,热量通过封装体框架、管体材料向周围环境散发。根据扩散规律,热流密度随着温度梯度的增加而增加。一般情况下,功率器件的芯片面积大且厚度小,可以认为热量传递的路径只存在于垂直于芯片截面的方向,此时可以用一维模型计算热流密度Q:
Q=-κ(1)
式中:κ为材料的热导率(W/cm);负号表示热量从温度高的地方向温度低的地方传递。
假设芯片横截面积为A,热量流经的长度为L,则在达到动态平衡时,单位时间内芯片产生的热量等于器件发散的热量,即:
Pc=Q·A(2)
将其代入式(1)得:
=-κ(3)
将式(3)积分得:
dx=-dT(4)
Pc=TJ-Ta(5)
令热阻:
RT =(6)
则在动态热平衡时:
Pc=(TJ-Ta)/RT(7)
其中式(6)是物理学热阻公式,式(7)是数学计算公式[2]。
2 测试方法与原理
在测试之前,需要选定好合适的温度敏感参数TSP、测试电流Im、温度校准系数K,其中温度敏感参数TSP的理论基础是p-n结正向压降与温度的关系[3-4]:
VF=Vg(0)lnT-n T r(8)
式中:VF为p-n结正向压降;Vg(0)为0 K时价带和导带之间的电位差;k为玻耳兹曼常量;q为电荷常数;c为依赖于结面积和掺杂密度的常数;r也是常数;IF为正向电流。
通过选取合适的TSP,获得TSP与温度之间的关系曲线,从而计算出结温。MOSFET一般选取漏极和源极之间的寄生二极管正向压降VSD作为TSP;测试电流Im用于获取TSP与温度之间的关系,Im既不能过大使芯片产生自热效应,也不能过小无法使p-n结导通,获取不到压降数据。在一定的测试电流Im下,温度敏感参数TSP随温度变化曲线斜率的倒数称为温度校准系数K,它表示电参数与结温的关系。
熱阻测试标准JESD51-14介绍了一种满足一维导热路径条件的半导体器件结壳热阻测试方法——瞬态双界面测试法,其主要步骤如下:
(1)选取合适的TSP,计算K系数。
(2)采集瞬时结温。首先将器件固定在水冷型测试夹具上,夹具通以冷却水,如图1所示[5]。然后施加加热电流IH,使器件得到充分加热且处于热平衡状态时,再将加热电流IH快速切换至测试电流Im,在降温过程中实时采集TSP,经过K系数换算得到结温,绘制降温曲线。
(3)把降温曲线转变为热阻抗曲线。在器件达到热平衡前,器件在任意时刻均可通过结温计算出此时器件的热阻,此热阻随时间变化而变化,称为瞬时阻抗,即:
ZθJC=(9)
式中:TJ(t)为随时间变化的结温;TJ0为t=0 s时的结温;PH为加热功率。
根据上述定义,得到热阻抗曲线[6]。
将器件直接与热沉接触以及将器件通过导热硅胶与热沉接触,按照上述步骤得到两条对应的瞬态热阻抗曲线。对同一器件来说,其内部热量传递路径是一样的,不随散热条件的变化而变化,因此热阻抗曲线也是一样的。当热量传递到封装表面以后,在不同散热环境中的散热路径也不同,从而使得热阻抗曲线发生变化。因此,两条热阻抗曲线的重合部分对应的就是热量在器件内部传递路径的热阻,两者的分离点对应的热阻就是结壳热阻。
(4)根据器件热阻值的大小确定结壳热阻RthJC。通常有两种方法用于确定结壳热阻:对热阻值不超过1 K/W的器件,其结壳热阻可由热阻抗曲线的分离点来确定,如图2所示[5];对热阻值大于1 K/W的器件,其结壳热阻可由结构函数的分离点来确定(结构函数由热阻抗曲线经数学变换得到),如图3所示。当器件的热阻值未知时,同时使用两种方法测试,取两者中的较大值。
3 实验结果与分析
本文选择的器件是上海韦尔半导体公司新开发的p沟道单芯片MOSFET,暂时命名为PMOS1、PMOS2,测试电路板为标准1 inch覆铜热测试板。
3.1 实验结果
经测试,得到PMOS1和PMOS2在不同栅极电压VGS下测得的热阻值,如图4所示。
根据测试数据可知,MOSFET的瞬态热阻随VGS绝对值的增加而减小,对于不同类型的MOSFET结论是相同的,并且实验具有可重复性。
3.2 结果分析
针对实验结果,可以从以下方面分析原因:
从电路的角度来看,通过改变栅极偏置电压可以改变通道的导通电阻。以某一器件为例,其导通电阻特性如图5所示,当沟道完全打开时,导通电阻从50 mΩ减小到14 mΩ。此外,基板和打线的电阻约为几毫欧,对低导通电阻器件来说,当通道完全打开时,基板和键合线可以从通道共享部分加热功率,从而降低芯片的发热量和热阻。
MOSFET的导通电阻是由以下电阻串联而成,因此导通电阻等于这些电阻的和[7]:
RON=RCS+RN+RCH+RA+RJFET+RD+RSUB+RCD(10)
其中源極接触电阻RCS和漏极接触电阻RCD由工艺条件决定,可以做得很小,可忽略不计;并且源区和衬底的掺杂浓度高,电阻比较小,因此源区电阻RN和衬底电阻RSUB也可忽略不计。因此,导通电阻主要由沟道导通电阻RCH、JFET区电阻RJFET、累积层电阻RA和漂移区电阻RD组成,这些区域产生的热量组成芯片内部总的热量。当VGS增大时,RCH、RA都会相应减小,从而芯片的发热量减少。
在测试MOSFET的热阻时,是以漏极、源极之间的寄生二极管的正向压降VSD作为TSP,因此热阻的温度监测点为基区与漂移区之间的p-n接点,p-n结可以看作是“温度计”。距离上,对于典型的MOSFET,导电通道与p-n结之间的距离总是比漂移区的距离短得多,导电通道比漂移区更接近p-n结,因此低击穿电压MOSFET沿导电通道的导通电阻分布较大,当VGS增大时,导电通道电阻相应减小,芯片的发热量减少。
综上所述,当VGS增大时,器件的芯片发热量减少,根据热阻计算公式,芯片热阻减小。
4 结语
对大多数沟道栅MOSFET而言,沟道和漂移区的物理尺寸对热流的扩散长度有显著影响。晶圆设计决定了MOSFET的电阻分布,也影响了瞬态热阻[8]。相关实验表明,具有高击穿电压、厚衬底、漂移区电阻高的芯片对瞬态热阻测量中的栅极偏置不太敏感。分析表明,在短脉冲时间内,芯片的瞬态热性能不仅与封装过程有关,还受到芯片结构的影响。当栅极偏置变化时,导电通道内的峰值温度点会发生变化,门栅温度的变化也会导致导电通道内的峰值温度的变化。从改变栅极电压观察热阻测量的结果来看,栅极制造工艺、芯片尺寸、芯片内部微观结构的热电学性能,包括沟槽、沟道、p-n结、基材,都会对器件的瞬态热阻测量造成影响。
[参考文献]
[1] 圆山重直.传热学[M].王世学,张信荣,译.北京:北京大学出版社,2011.
[2] 周志敏,周纪海,纪爱华.IGBT和IPM及其应用电路[M].北京:人民邮电出版社,2006.
[3] BALIGA B J.功率半导体器件基础[M].韩郑生,陆江,宋李梅,等译.北京:电子工业出版社,2013.
[4] SHOCKLEY W.The theory of p-n junction in semiconductors and p-n junction transistors[J].Journal of Bell System Technical,1949,28(3):435-489.
[5] Transient Dual Interface Test Method for the Measurement of the Thermal Resistance Junction-
to-Case of Semiconductor Devices with Heat Flow Trough a Single Path:JESD 51-14[S].
[6] 陈铭,吴昊.功率器件热阻测试方法发展与应用[J].集成电路应用,2016,33(8):34-38.
[7] 王南南.功率MOSFET导通电阻的仿真研究[D].沈阳:沈阳工业大学,2020.
[8] DARWISH M N,BOARD K.Optimization of breakdown voltage and on-resistance of VDMOS transistors[J].IEEE Transactions on Electron Devices,1984,31(12):1769-1773.
收稿日期:2022-03-21
作者简介:刘超群(1993—),男,安徽人,在读硕士研究生,研究方向:集成电路应用。
- 上一篇:浅谈高职汽车类专业机械制图教学改革
- 下一篇:“画语”支持下儿童可视化学习的实践探究
猜你喜欢
- 2024-01-20 有关于第五次全国经济普查统计重点业务综合培训大会上讲话(完整文档)
- 2024-01-20 “严纪律、转作风、保安全、树形象”专题学习教育活动通知(完整文档)
- 2024-01-20 2024XX区住房城乡建设工作情况汇报
- 2024-01-20 2024高校思政教育交流材料:善用反腐败斗争这堂“大思政课”(精选文档)
- 2024-01-20 2024年主题教育专题党课辅导报告,(4)
- 2024-01-20 关于赴某地学习考察地方立法工作情况报告(范文推荐)
- 2024-01-20 2024年度关于增强党建带团建工作实效对策与建议(精选文档)
- 2024-01-20 教师演讲稿:春风化雨育桃李,,潜心耕耘满芬芳(全文)
- 2024-01-20 主题教育第二阶段来了
- 2024-01-20 2024年度关于到信访局实践锻炼个人总结【完整版】
- 搜索
-
- 打赌输了任人处理作文1000字7篇 05-12
- 当代大学生在全面建设社会主义现代化强 05-12
- 全面建成社会主义现代化强国的战略安排 03-10
- 个人廉洁自律方面存在的问题及整改措施 05-12
- 谈谈青年大学生在中国式现代化征程上的 05-12
- 2022年党支部第一议题会议记录(全文完 11-02
- 作为青年大学生如何肩负时代责任6篇 05-12
- 村党组织建设现状及工作亮点存在问题与 05-12
- 全面从严治党,自我革命重要论述研讨会 05-12
- 产业工人队伍建设改革(全文完整) 10-31
- 11-25国庆70周年庆典晚会 庆典晚会串词
- 11-25办公室礼仪的十大原则 浅谈办公室的电话礼仪
- 01-17用心灵轻轻地歌唱_心灵的歌唱
- 01-17也许你不是我一生的唯一|也许不是我
- 01-17爱了,请珍惜;不爱,趁早放手|爱就珍惜不爱就放手
- 01-17岁月带走的是记忆,但回忆会越来越清晰|有趣又有深意的句子
- 01-17曾经的美好只是曾经,我只想珍惜身边的人|我只想珍惜你
- 01-18从容不惊 [学会笑眼去看世界,不惊不乍,淡定从容]
- 02-03当代大学生学习态度调查报告
- 02-03常用护患英语会话
- 标签列表
